The Differences Between Scanning Electron Microscope (SEM) and Transmission Electron Microscope (TEM)
มนุษย์อาศัยประสาทสัมผัสของตนเองในการรับรู้โลก และเครื่องมือวิเคราะห์ในระดับจุลภาคเหล่านี้ก็เป็นเสมือนการ “ขยายขอบเขตการรับรู้ของมนุษย์” ให้ลึกซึ้งยิ่งขึ้น
เราต่างคุ้นเคยกับ กล้องจุลทรรศน์แสง (Optical Microscope) ซึ่งทำงานโดยอาศัยหลักการของการสร้างภาพผ่านเลนส์ แต่กล้องเหล่านี้มีข้อจำกัดตาม “ขีดจำกัดของอับเบ (Abbe Limit)” กล่าวคือ ความละเอียด (resolution) ของภาพไม่สามารถสูงกว่าครึ่งหนึ่งของความยาวคลื่นแสงที่ใช้ได้
ดังนั้น ความละเอียดของกล้องจุลทรรศน์แสงจึงอยู่ในระดับไมโครเมตร เนื่องจากถูกจำกัดด้วยความยาวคลื่นของแสงเอง
ในทางกลับกัน อิเล็กตรอนที่เคลื่อนที่ด้วยความเร็วสูงมีสมบัติทั้งเป็นคลื่นและอนุภาค (เรียกว่า dual nature of wave and particle) และในฐานะที่เป็นคลื่น “ความยาวคลื่นของอิเล็กตรอน” ถือเป็นปัจจัยสำคัญที่ส่งผลต่อความสามารถในการแยกรายละเอียดของภาพ
เมื่อแรงเร่งไฟฟ้า (Acceleration Voltage) เพิ่มขึ้น ความยาวคลื่นของอิเล็กตรอนจะสั้นลง ตัวอย่างเช่น เมื่อใช้แรงเร่งประมาณ 30 กิโลโวลต์ (kV) จะได้ลำอิเล็กตรอนที่มีความยาวคลื่นเพียง ประมาณ 7 พิโกเมตร (pm) ซึ่งสั้นกว่าแสงที่ตามองเห็นนับพันเท่า
กล้องจุลทรรศน์อิเล็กตรอน (Electron Microscope) จึงถูกสร้างขึ้นโดยใช้อิเล็กตรอนเป็น “แหล่งกำเนิดแสง” และแทนที่เลนส์แก้วของกล้องจุลทรรศน์แสงด้วย เลนส์แม่เหล็กไฟฟ้า (Magnetic Lens) เพื่อโฟกัสลำอิเล็กตรอนให้ได้ภาพที่มีความละเอียดสูงยิ่งกว่าเดิม
เมื่ออิเล็กตรอนชนกับตัวอย่างของแข็ง จะเกิดสัญญาณหลากหลายรูปแบบที่สัมพันธ์กับตัวอย่างนั้น เช่น
แรงเคลื่อนไฟฟ้าที่เหนี่ยวนำ (Induced Electromotive Force), การเรืองแสงคาโทโดลูมินีเซนซ์ (Cathodoluminescence), รังสีเอกซ์ลักษณะเฉพาะของธาตุ (Characteristic X-rays), อิเล็กตรอนสะท้อนกลับ (Back-scattered Electrons), อิเล็กตรอนออกเกอร์ (Auger Electrons), อิเล็กตรอนทุติยภูมิ (Secondary Electrons), อิเล็กตรอนดูดกลืน (Absorbed Electrons) และอิเล็กตรอนส่งผ่าน (Transmitted Electrons) เป็นต้น
โดยการวิเคราะห์และนำสัญญาณเหล่านี้มาใช้ นักวิทยาศาสตร์สามารถสร้างข้อมูลเชิงโครงสร้างของวัสดุในระดับจุลภาคได้อย่างละเอียดและแม่นยำ ซึ่งถือเป็นหัวใจสำคัญของเทคโนโลยี Scanning Electron Microscope (SEM) และ Transmission Electron Microscope (TEM) ในปัจจุบัน
ความแตกต่างระหว่าง SEM และ TEM
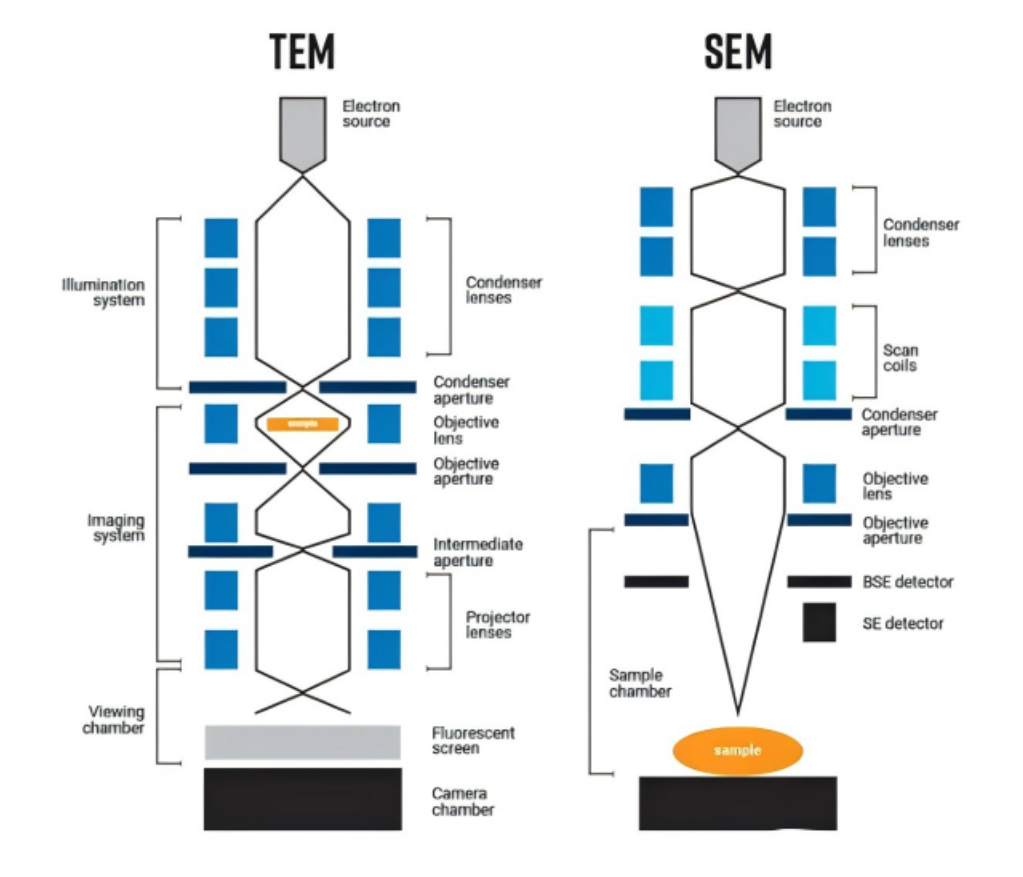
SEM (Scanning Electron Microscope) และ TEM (Transmission Electron Microscope) เป็นรูปแบบที่พบได้บ่อยที่สุดของกล้องจุลทรรศน์อิเล็กตรอน ทั้งสองระบบใช้ลำอิเล็กตรอนเป็นแหล่งพลังงานหลักในการสร้างภาพ แต่มีหลักการทำงานที่แตกต่างกันอย่างมีนัยสำคัญ
SEM ใช้สัญญาณจาก อิเล็กตรอนทุติยภูมิ (Secondary Electrons; SE) และ อิเล็กตรอนสะท้อนกลับ (Back-scattered Electrons; BSE) ในการสร้างภาพพื้นผิวของตัวอย่าง ขณะที่ TEM ตรวจจับ อิเล็กตรอนที่ส่งผ่าน (Transmitted Electrons) เพื่อสร้างภาพแบบฉายผ่าน (Projection Image) ของโครงสร้างภายในตัวอย่าง
ในกระบวนการทำงานของ SEM ลำอิเล็กตรอนที่ถูกโฟกัสให้แคบและเข้มข้นจะทำการ “สแกน” บนพื้นผิวตัวอย่างทีละจุด โดยสัญญาณที่เกิดขึ้นในแต่ละตำแหน่งจะถูกตรวจจับและประมวลผลเพื่อสร้างภาพขยายขึ้นมาแบบพิกเซลต่อพิกเซล (Pixel-by-pixel reconstruction)
Scanning Coil ซึ่งอยู่ใต้เลนส์วัตถุ (Objective Lens) จะควบคุมทิศทางของลำอิเล็กตรอนให้สแกนได้อย่างแม่นยำในระนาบ X–Y ของตัวอย่าง
ขึ้นอยู่กับกำลังขยายที่ต้องการ (สูงสุดได้ถึง 2,000,000 เท่า) พื้นที่ที่ลำอิเล็กตรอนสแกนครอบคลุมอาจมีขนาดตั้งแต่ไม่กี่ไมโครเมตรไปจนถึงหลายมิลลิเมตร
แรงเร่งไฟฟ้าทั่วไปของ SEM อยู่ในช่วงประมาณ 1 kV – 30 kV
แรงเร่งต่ำให้ลำอิเล็กตรอนที่ “อ่อนโยนกว่า” เหมาะสำหรับตัวอย่างที่ไวต่ออิเล็กตรอน เช่น วัสดุอินทรีย์ หรือวัสดุฉนวน
Secondary Electrons (SE) จะตอบสนองน้อยต่อเลขอะตอมของธาตุ (Atomic Number) จึงเหมาะสำหรับการสังเกตลักษณะภูมิประเทศผิว (Surface Topography)
ในขณะที่ Back-scattered Electrons (BSE) จะให้สัญญาณที่แรงขึ้นกับธาตุที่มีเลขอะตอมสูง ทำให้สามารถแยกความแตกต่างขององค์ประกอบวัสดุ (Compositional Contrast) ได้ชัดเจน
กล่าวโดยสรุป SEM เหมาะสำหรับการศึกษาลักษณะผิวและองค์ประกอบของวัสดุ ในขณะที่ TEM ใช้สำหรับวิเคราะห์โครงสร้างภายในในระดับอะตอม
กล้องจุลทรรศน์อิเล็กตรอนแบบส่องผ่าน (Transmission Electron Microscope – TEM)
โดยทั่วไปทำงานภายใต้แรงเร่งไฟฟ้าระหว่าง 30 kV ถึง 300 kV ซึ่งสูงกว่ากล้อง SEM หลายเท่า
แรงเร่งที่สูงนี้ช่วยให้ได้ความละเอียดของภาพมากขึ้นอย่างมีนัยสำคัญ โดยเฉพาะในรุ่น TEM ที่มีระบบแก้ความคลาดของเลนส์ (Corrected Aberration TEM) สามารถให้ความละเอียดเชิงพื้นที่ (Spatial Resolution) ต่ำกว่า 1 Ångström (1 Å = 0.1 นาโนเมตร) ซึ่งทำให้สามารถสังเกตรายละเอียดระดับอะตอมได้ เช่น การจัดเรียงตัวของอะตอมภายในอนุภาคนาโน
ในกระบวนการสร้างภาพของ TEM ลำอิเล็กตรอนจะถูกขยายให้เป็นลำกว้าง (Broad Beam) เพื่อส่องผ่านตัวอย่าง จากนั้นตรวจจับอิเล็กตรอนที่ส่งผ่านออกมาในเฟรมเดียว แตกต่างจาก SEM ที่ต้องอาศัยการ “สแกน” ลำอิเล็กตรอนทีละจุดด้วย Scanning Coilใน TEM ระบบส่องสว่าง (Illumination System) จะสร้างลำอิเล็กตรอนขนาดใหญ่และสม่ำเสมอครอบคลุมพื้นที่ตัวอย่างทั้งหมดในคราวเดียว
กล้อง TEM สามารถให้กำลังขยายได้มากกว่า 50 ล้านเท่า (50,000,000×)
ทำให้สามารถ “มองเห็นโดยตรง” ถึงโครงสร้างผลึกในระดับอะตอม อย่างไรก็ตาม ตัวอย่างที่ใช้ในการวิเคราะห์ด้วย TEM ต้องมีความบางมาก — ปกติน้อยกว่า 100 นาโนเมตร — เพื่อให้อิเล็กตรอนสามารถทะลุผ่านได้
อิเล็กตรอนที่ส่งผ่าน (Transmitted Electrons) ใน TEM สามารถจำแนกออกได้เป็นหลายประเภท เช่น
Direct Beams (ลำอิเล็กตรอนตรง)
Diffracted Beams (ลำอิเล็กตรอนที่เลี้ยวเบน)
ซึ่งนำไปสู่โหมดการทำงานสองลักษณะคือ Imaging Mode และ Diffraction Mode
ในโหมดเลี้ยวเบน (Diffraction Mode) ชุดเลนส์กลาง (Intermediate Lens) และช่องเลนส์วัตถุ (Objective Aperture) ที่อยู่ใต้ตัวอย่างสามารถปรับแต่งได้ เพื่อสร้างภาพจากรูปแบบการเลี้ยวเบนเฉพาะ (Specific Diffraction Pattern)
ข้อมูลเหล่านี้ช่วยให้นักวิทยาศาสตร์สามารถทำความเข้าใจ โครงสร้างผลึก (Crystal Structure) และ ตำหนิของวัสดุ (Defects) ได้อย่างละเอียดและแม่นยำ
✅ สรุปจุดเด่นของ TEM
แรงเร่งสูง (30 – 300 kV) → ความละเอียดระดับอะตอม
ไม่ต้องสแกนทีละจุด → สร้างภาพฉายผ่านในเฟรมเดียว
กำลังขยายสูงสุด > 50 ล้านเท่า
ต้องใช้ตัวอย่างบาง < 100 nm
วิเคราะห์ได้ทั้ง ภาพเชิงโครงสร้าง (Imaging) และ รูปแบบการเลี้ยวเบน (Diffraction) เพื่อศึกษาผลึกและจุดบกพร่อง
STEM (Scanning Transmission Electron Microscope)
มีหลักการทำงานคล้ายกับ TEM (Transmission Electron Microscope)
แต่ได้รับการพัฒนาเพิ่มเติมด้วย ระบบคอยล์สแกน (Scan Coils), ตัวตรวจจับสัญญาณ (Detectors) และ วงจรอิเล็กทรอนิกส์ควบคุม เพื่อให้สามารถสแกนลำอิเล็กตรอนบนตัวอย่างได้อย่างละเอียดและเป็นระบบ
ในโหมด STEM ลำอิเล็กตรอนจะถูกโฟกัสให้เป็นจุดเล็กมาก — โดยทั่วไปมีขนาดจุด (Spot Size) อยู่ในช่วงประมาณ 0.05–0.2 นาโนเมตร จากนั้นจะถูกสแกนไปบนตัวอย่างตามลักษณะตาราง (Raster Grid)
ลำอิเล็กตรอนซึ่งเคลื่อนที่ขนานกับแนวแกนเชิงแสง (Optical Axis) จะส่องสว่างและตรวจจับสัญญาณที่เกิดจากแต่ละตำแหน่งของตัวอย่างทีละจุด
กล่าวคือ STEM เป็นการผสานข้อดีของทั้ง SEM และ TEM เข้าด้วยกันจาก TEM ได้ความสามารถในการตรวจจับอิเล็กตรอนที่ส่งผ่าน (Transmitted Electrons) เพื่อวิเคราะห์โครงสร้างภายใน และจาก SEM ได้หลักการ “การสแกนแบบจุดต่อจุด (Point-by-Point Scanning)” ซึ่งทำให้สามารถเก็บข้อมูลเชิงพื้นที่และเชิงสัญญาณได้อย่างละเอียดในระดับอะตอม
ในระบบ STEM มักติดตั้ง Detectors หลายชนิด รอบบริเวณตัวอย่าง เช่น
Annular Dark Field (ADF) Detector สำหรับจับสัญญาณอิเล็กตรอนเลี้ยวเบนมุมกว้าง
High-Angle ADF (HAADF) สำหรับสร้างภาพที่มีคอนทราสต์ขึ้นกับเลขอะตอม (Z-contrast imaging)
Bright Field (BF) Detector สำหรับตรวจจับอิเล็กตรอนที่ผ่านตรงกลางลำ
ดังนั้น STEM จึงเป็นเทคนิคที่มีความยืดหยุ่นสูง สามารถใช้ได้ทั้งเพื่อสร้างภาพเชิงโครงสร้าง (Imaging) และวิเคราะห์เชิงองค์ประกอบหรือผลึก (Analytical and Diffraction Studies) ในระดับอะตอมได้พร้อมกัน